▶ 全部真空内完成
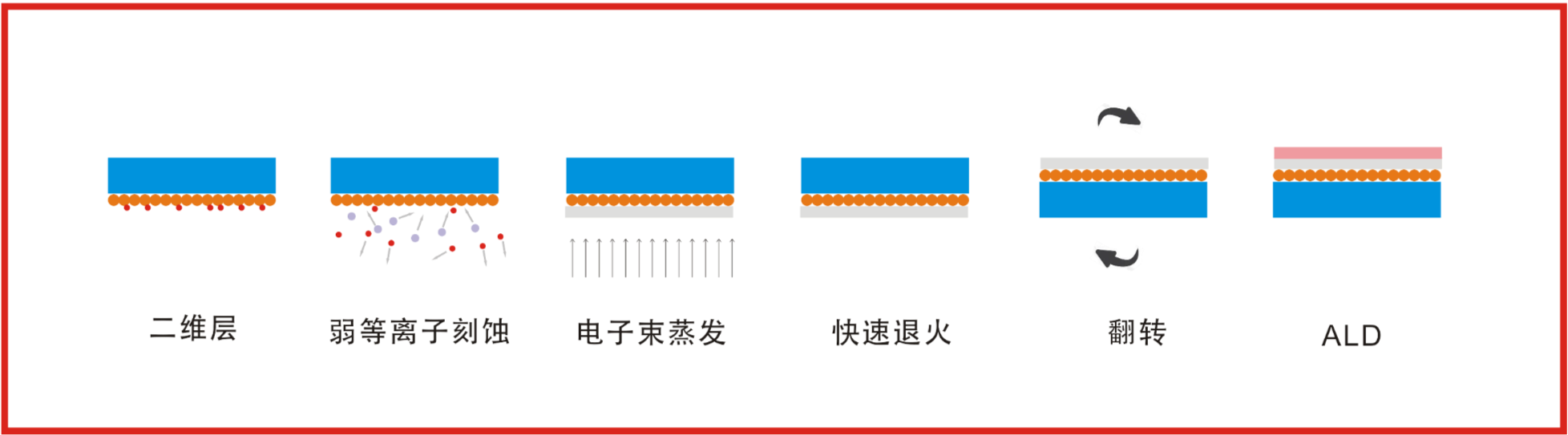
▶ 系统核心难点
1、多工艺设备技术储备
•PVD(电子束蒸发、磁控溅射、ALD)
•刻蚀(去胶刻蚀RIE、介质刻蚀ICP-RIE、远程等离子刻蚀)
•快速退火(HTE)、预处理
2、基片在真空系统内翻转
3、工艺面向下时基片传输和夹取
4、各个不同工艺之间的衔接
5、控制系统的算法
▶ Cluster功能腔设计
| 栅介质工艺模组 | 接触工艺模组 |
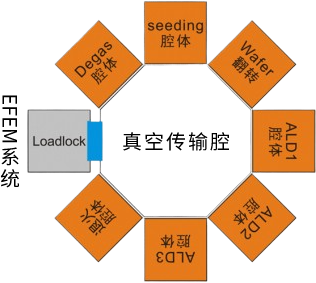 |
 |
|
Degas腔体:用于薄膜生长前,去 除表面杂质与水汽; seeding腔体:ebe腔体,用于SiO2以及Al2O3蒸镀; Wafer翻转腔体:用于翻转wafer; ALD1腔体:用于生长HfO2薄膜; ALD2腔体:用于生长HfO2薄膜; ALD3腔体:用于生长Al2O3薄膜; 退火腔体:用于seeding退火以及后续介质后退火。 |
Degas腔体:去除表面杂质与水汽; 金属1腔体:远程弱等离子体处 理+金属阻蒸; 金属2腔体:远程弱等离子体处 理+金属阻蒸; 金属3腔体:ebe+阻蒸; Wafer翻转腔体:翻转wafer; 蚀刻腔体:蚀刻介质+二维材料; 退火腔体:器件退火,可选普通 退火或者快速退火(大于100℃/S)。 |
▶ 技术储备




